服務熱線


嵌入式液冷技術通過將微通道冷卻塊直接集成到芯片封裝中,實現了熱源與冷卻介質的緊密耦合,顯著降低了熱阻,提高了散熱效率。例如,JetCool為NVIDIA H100 GPU設計的SmartPlate采用單相直接芯片液冷技術,具有0.021°C/W的低熱阻,支持高達1500W的散熱功率 。
此外,嵌入式液冷還具有降低能耗、降低噪音和節省空間等優勢。例如,Supermicro與英偉達合作的液冷AI開發平臺,采用液冷系統可降低高達40%的電力使用,提升AI工作負載效率 。
一、什么是嵌入式液冷?
嵌入式液冷是把液體冷卻系統“集成進”芯片或封裝內,而不是像傳統那樣把散熱器掛在芯片外邊。具體來說是在CPU封裝(IHS 或直接在封裝外殼)上集成一個微通道冷卻塊,液體通過這些微通道直流熱點區域帶走熱量。這種做法,將熱源和冷卻介質之間的熱阻降到最低。
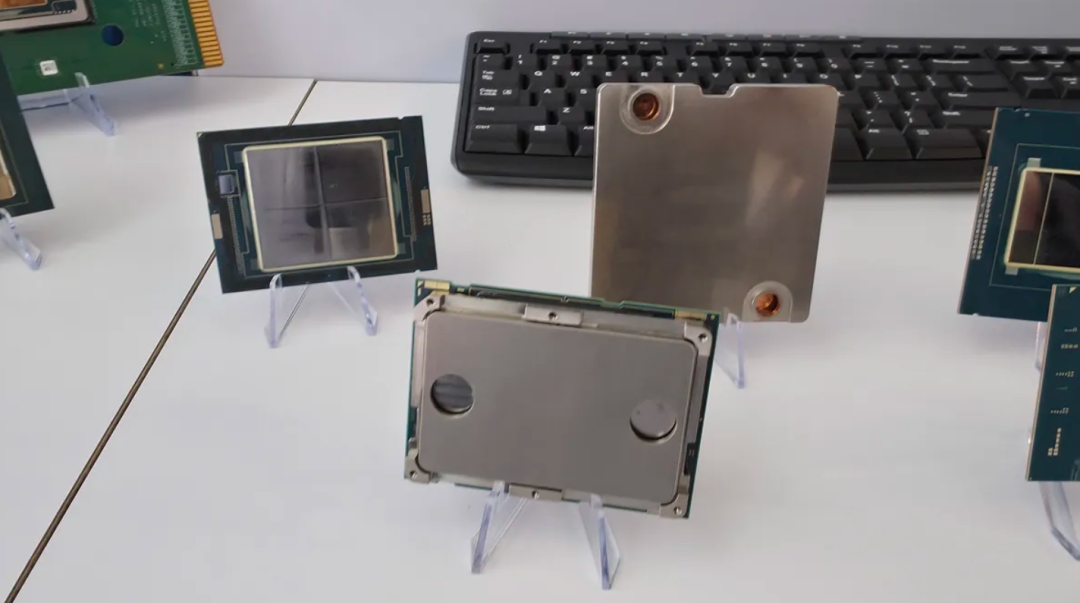
Intel 已在其 Foundry Direct Connect 展會上展示過原型:銅制微通道冷卻塊直接安裝在 CPU 包裝頂部,配合液態金屬或焊料 TIM 層,冷卻功率可達 1000?W,效率比傳統 delid 后水冷系統高 15?20%。
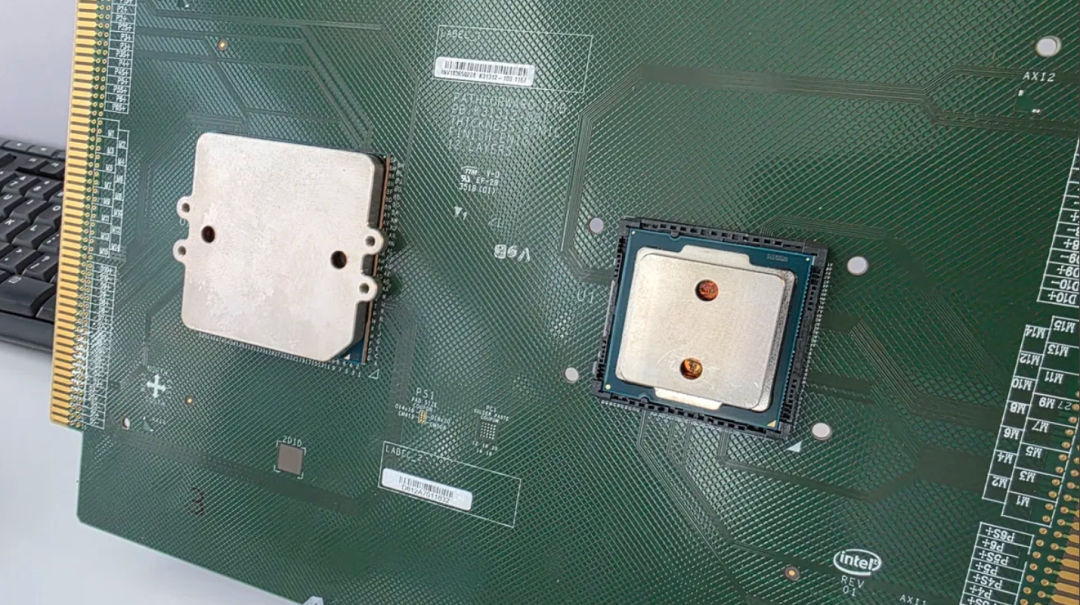
二、核心組成與實現方式
1. 微通道冷卻塊(Copper microchannel block)
制作在銅或高熱導材料中,通過精密刻蝕或加工形成微通道。
流體沿最低熱阻路徑直擊熱點區域,因此冷卻更精準、更高效。
2. 熱界面材料(TIM)
使用液態金屬或焊料替代傳統導熱硅脂,這樣能更緊密地將封裝頂部與冷卻塊接觸,減少熱界面熱阻,從而提升熱傳遞效率。
3. 封裝集成方式
該冷卻結構通常設計為與 LGA 或 BGA 封裝兼容,安裝后成為封裝的一部分,不需要額外大體積散熱器。
對未來 AI、HPC、服務器工作站等高熱密度應用能有效滿足散熱需求。

三、優點分析
熱阻最小:熱流路徑短、更直接,封裝到冷卻液僅一層 TIM。
精準針對熱點:通道布局可根據芯片內部熱點分布(如高功耗電核等)規劃,增強局部冷卻效率。
能量擺放更緊密:冷卻塊極薄,可支持高度集成、高功耗芯片設計。
整體系統體積更小:無需傳統大型散熱器或 AIO 水冷器,封裝本身即冷卻單元。
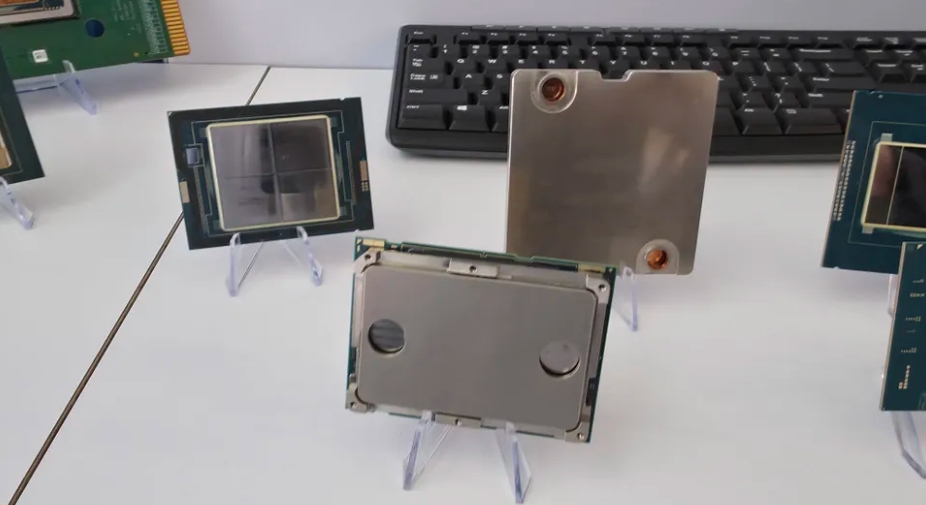
四、局限及挑戰
1. 工藝與制造難度
在封裝頂部集成微通道水冷結構,制造工藝復雜,對封裝精度、材料選擇、流體密封要求高;
需求與芯片設計緊密耦合,從封裝設計端就需協作定制。
2. 流體與氣泡管理
當流量或溫度設計碰到兩相區(液體沸騰區域),會產生氣泡,影響流動路徑與熱交換性能;
要精控微通道幾何結構、入口壓力、流速等參數,避免氣堵、沸騰不均、局部干涸。
3. 系統設計與可靠性
封裝內流速過高可能會引起壓力損失、結構振動,甚至泄漏;
TIM、銅塊、封裝接合界面必須長期穩定、耐熱循環,防止疲勞失效。
五、整體技術流程(系統性梳理)
| 聯合芯片+封裝+熱設計協作 | ||
| 封裝集成微通道冷卻塊 | ||
| 液態金屬或焊料 TIM | ||
| 管路、泵、流速控制 | ||
| 熱性能驗證與可靠性測試 | ||
| 部署在高功耗AI、HPC服務器 |
六、總結一句話
嵌入式液冷就是把「微型銅制水冷塊」直接集成到封裝上,并通過液態金屬 TIM 層緊耦合在封裝與液體之間,能把熱流路徑拉到最短,實現高達 1000?W 的散熱能力,是為高熱密度芯片而生的一種顛覆性散熱技術。不過,對制造、流體控制、長期可靠性都提出了很高要求。
免責聲明:本文采摘自“老虎說芯”,本文僅代表作者個人觀點,不代表薩科微及行業觀點,只為轉載與分享,支持保護知識產權,轉載請注明原出處及作者,如有侵權請聯系我們刪除。






 粵公網安備44030002007346號
粵公網安備44030002007346號